
摘 要: 半导体的性能和可靠性与器件的封装形式密切相关,而引线键合工艺无疑是其中重要且容易出现失效的一环,其失效大约占总失效的1/3。因此,对引线键合工艺的深入理解对器件封装至关重要。本文全面深入地阐述了引线键合工艺,包括引线键合的多种工艺方法、引线键合的技术原理与特点、引线键合的打线方式、引线键合的实际应用以及引线键合常见的失效形式等。本文对引线键合的综合性论述工作对器件封装的设计和制造有着重要的启引作用。
关键词: 封装;键合机理;键合工艺;键合材料;打线形式;键合失效
Research on Power Device Wire Bonding Technology: A Review
NS Technical Literature of the Third Gen-Semiconductor Project Team
Abstract The performance and reliability of semiconductors are closely related to the packaging form of devices, and the wire bonding process is undoubtedly an important part and is prone to failure, which the wire bonding failures account for about 1/3 of the total failures. Therefore, an deep understanding of the lead bonding process is very important for device packaging. This article comprehensively elaborates on the wire bonding process, including the various techniques, the technical principles and characteristics, the bonding methods, and the practical applications and the common failure modes of wire bonding. It is believed that the comprehensive exposition of the wire bonding in this article has an important inspiration for device packaging.
Keywords packaging;bonding mechanism;bonding process;bonding materials;bonding forms;bonding failure
接上一篇....
在器件封装流程中,引线键合是一项十分关键的工艺步骤,引线的洁净度、键合的稳定性等等都与封装的可靠性息息相关。因此,我们需要对其塑封前后的引线进行可靠性测试与失效分析,主要分为键合失效与可靠性失效两种模式,对应分析其失效因素,从而对工艺流程进行调整,改善产品的可靠性[13]。
5.1 键合失效
在进行键合工艺的封装流程中,往往会有许多失效情况出现,常见的有外观问题、焊线拉力失效、焊点推力失效、焊盘清洁度程度不足、焊盘出现弹坑等等。
5.1.1 工艺失效
以金线球焊为例,其外观检测主要是烧球外观、拉线外观。其中烧球失效包括烧球尺寸、形状、稳定性、滑球等等;拉线失效包括金线残留不符要求、弧度不良、各个节点(一般是A、D、E点)不良等等。
焊线拉力与焊点推力是焊线质量评判的一个重要指标,其很好地反映引线的应力与焊点的牢固性,只有达到一定的标准才能保证器件的可靠性。如图18所示,其在焊线的时候就会自动对引线进行一次拉力测试,焊线条数对应检验次数(15mil会施加250g的拉力,20mil会施加300g的拉力)。可以看到,相比于拉力标准,这个拉力是偏小的,因为这一步骤是为了检验焊点是否存在虚焊的现象,不仅大大提高了检验的效率,也降低了器件的不合格率。
焊线结束后,会使用专门的钩针与推针进行测试,机器会记录焊线断开与焊点移动的力量数据,从而与标准比较,判定产品是否符合推拉力要求。钩针一般在线弧最高点进行钩线,断点不同原因不同;而推针一般高于电极5μm。
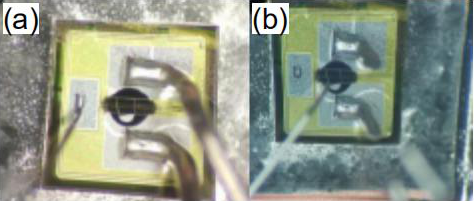
图18 器件推拉力结果:(a)推拉力前、(b)推拉力后
Fig.18 Power device push-pull test results: (a) before push-pull, (b) after push-pull
5.1.2 焊盘清洁度
焊盘清洁度在焊线工艺也是造成失效的一个因素,焊点的牢固性与其息息相关,虚焊也经常发生在清洁度不足的焊盘上。卤化物、清洗残留、镀层污染等都是造成焊盘污染的重要因素。
5.1.3 弹坑
弹坑是键合失效中常见的问题,其经常发生在高强度加压加能量的超声焊接。弹坑是指焊盘金属化层或其下方的半导体材料层的机械损坏,如图19(a)所示。这种损坏,有时可见为凹痕或裂纹,或更常见的是对材料结构看不见的损坏,会降低半导体器件的性能并引起电损坏,增加器件故障的风险。造成弹坑这种现象往往有两个因素:引线硬度较大以及键合参数不匹配芯片材料脆性。
以铜线为例,烧球时铜线极易氧化,由于其氧化物硬度较大,往往在键合中会对焊盘造成损伤,因此在铜线键合时需要气体进行保护;引线与焊盘的键合参数是否匹配也对弹坑有着相应的影响,因此设备参数也需要慢慢调试,尽量避免弹坑形成;另外,在球焊中如果烧球较小也有可能因为键合头过硬接触焊盘形成弹坑。图19(b)是器件对铝线腐蚀后的效果图,图19(c)是其在显微镜下的弹坑观察图,可以看到其表面仅仅只有铝线键合时留下楔形痕迹,并没有明显的弹坑痕迹。
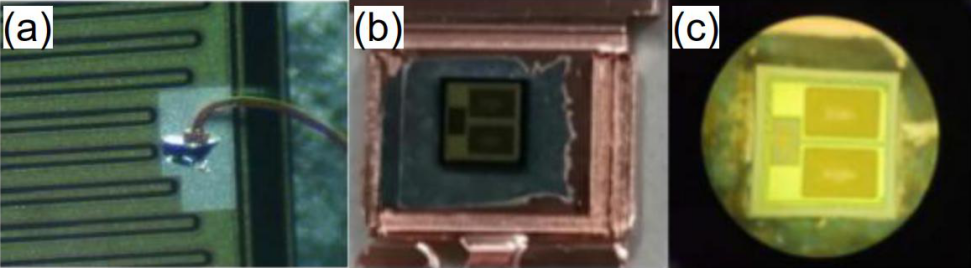
图19 (a)弹坑、(b)器件去铝线示意图、(c)显微镜下芯片外形图
Fig.19 (a) crater, (b) device corrosion, (c) chip appearance under microscope
5.2 可靠性失效
在器件投入工作后,难免会出现老化失效的可靠性问题,因此我们在整个封装流程结束后,需要对器件进行可靠性测试与相应的失效分析,其主要失效模式包括引线与焊盘表面金属间化合物的扩散、焊线疲惫劳损、焊点失效(剥离、腐蚀等等)等等。
5.2.1 金属间化合物的扩散
在引线与芯片焊盘键合的过程中,引线与表面铝垫存在金属扩散的情况,当两种不同扩散速率的金属相互接触并施加压力时,会出现柯肯达尔效应,虽然固体中扩散速度很慢,但随着时间推移,难免会产生可靠性问题。以键合金线为例,当金线键合在芯片电极铝垫上,经过长期环境因素影响,会形成紧密结合的化合物(“白斑”和“紫斑”),并在其中形成孔洞。(“紫斑”的主要物质是AuAl2,一般是金线与铝垫在键合表面接触并扩散所产生的化合物与其它混合物,“白斑”的成分是Au2Al。)
5.2.2 焊线疲劳
器件投入应用后,其引线焊点处经常出现细微缺陷,在受到温度变化或其他环境因素影响下引线会发生形变,而缺陷也会随之扩大。引线的拉伸弯曲会影响焊点处应力的变化,最终出现焊线疲劳,更严重的是,随着环境温度的变化,这种失效会经常出现。经验证,当引线弧高超过两个焊点间距的四分之一时,线弧会出现塌陷的问题。
5.2.3 键合焊点失效
在可靠性测试中的环境老化试验下,键合焊点失效也是经常发生,在冷热冲击中,温度的冷热交替会造成焊点剥离,甚至延伸到焊线;另外,在湿度较高的环境下,焊点也会出现锈蚀的状况,锈蚀会造成电路故障以及增加键合点的电阻等失效。
引线键合作为封装工序重要的工艺环节,对器件的性能表现和长期可靠性有着重要的影响,对焊线工艺的深入理解在封装工作中至关重要。本文对引线键合进行了全面详细地介绍:
(1) 引线键合常见的三种工艺方法可分为热压键合、超声键合以及热压超声键合;热压超声键合可使超声波功率和焊接压力减小,保护芯片,是目前主流的引线键合方法。
(2) 根据焊点的形状,引线键合可分为球形键合与楔形键合。一般球形键合适用于金线焊接,楔形键合适用于铝线焊接以及键合引线的特点。
(3) 根据成本和电流密度区分,一般小功率器件选用金线键合,而高功率的功率器件则选用铝线键合。
(4) 引线键合常见的失效形式主要有:键合失效与可靠性失效。键合失效主要分为工艺失效、焊盘清洁度与弹坑;可靠性失效主要包括金属间化合物的扩散、焊线疲劳与焊点失效。
(完结)
[1] CSIA.国务院关于印发新时期促进集成电路产业和软件产业高质量发展若干政策的通知
[EB/OL].(2020-08-05)[2021-03-04].http://www.csia.net.cn/Article/ShowInfo.asp?InfoID=95726.
[2]晁宇晴, 杨兆建, 乔海灵. 引线键合技术进展[J]. 电子工艺技术, 2007, 28(004):205-210.
[3] 斯芳虎.LED金线键合工艺的质量控制[J].电子质量,2010(03):44-45+48.
[4] 杨阳.功率器件封装铝带键合失效分析及工艺优化[D].南京:东南大学,2019.
[5] 李锟.集成电路铜引线键合强度试验方法标准研究[J].信息技术与标准化,2020(11):56-60+66.
[6] 肖沛宏,付兴铭,谭六喜,等.压力传感器引线键合金线的振动疲劳研究[J].传感器世界,2007(03):10-12.
[7] 贺玲,刘洪涛.引线键合的失效机理及分析[J].微处理机,2017,38(06):17-20.
[8] 吴懿平.引线键合原理与工艺[J].环球SMT与封装,2007,7(6):8-10.
[9] 罗珏,康敏,赵鹤然,等.金丝键合短尾问题分析及解决[J].微处理机,2020,41(03):17-19.
[10] 王宁宁,何宗鹏,张振明,等.功率VDMOS器件粗铝丝键合工艺研究[J].电子工艺技术,2015,36(01):25-28.
[11] 廖雯,毛繁,但雪梅,等.一种瓦片式T/R的关键工艺分析[J].压电与声光,2018,40(03):323-325+330.
[12] 唐家霖,崔洁,柳青.键合引线悬空的引线键合工艺研究[J].电子工业专用设备,2016,45(08):5-8.
[13] 丁康伟. 半导体金线键合可靠性研究[D].北京:中国科学院大学(工程管理与信息技术学院),2014.
[14] 余斋. 改善热压超声球焊点键合强度的工艺研究[D].成都:西南交通大学,2010.
[15] 沙帕拉·K·普拉萨德,刘亚强(译).复杂的引线键合互联工艺[M].北京:中国宇航出版社,2015.9.
[16] 徐佳慧. 射频器件超细引线键合工艺及性能研究[D].哈尔滨:哈尔滨工业大学,2020.
[17] 吕磊.引线键合工艺介绍及质量检验[J].电子工业专用设备,2008(03):53-60.
[18] 侯育增. 功率外壳粗铝丝键合可靠性工艺研究[D].南京:南京理工大学,2013.
[19] 谭一帆. 基于新型层叠DBC混合封装功率模块的键合线可靠性研究[D].武汉:华中科技大学,2019.
[20]A. GRAMS, C. EHRHARDT, J. JAESCHKE,et al. "Simulation of the Lifetime of Wire Bonds Modified through Wedge Trenches for Higher Reliability," CIPS 2016; 9th International Conference on Integrated Power Electronics Systems, Nuremberg, Germany, 2016, pp. 1-4.
[21]W. HUANG, D. BAI AND A. LUO, "Stress simulation for 2N gold wires and evaluation on the stitch bond shapes," 2011 International Symposium on Advanced Packaging Materials (APM), Xiamen, 2011, pp. 134-140, doi: 10.1109/ISAPM.2011.6105722.
[22]J. ZHAO, F. QIN, T. AN, ,et al. "Electro-thermal and thermal-mechanical FE analysis of IGBT module with different bonding wire shape," 2017 18th International Conference on Electronic Packaging Technology (ICEPT), Harbin, 2017, pp. 548-551, doi: 10.1109/ICEPT.2017.8046514.
[23]段之刚. DFN1006新型引线键合设计与实现[D].成都:电子科技大学,2017.
[24] 燕子鹏,秦文龙,贺从勇.BSOB键合工艺在厚膜基板引线互联中的研究[J/OL].微电子学:1-5[2021-01-19].
刘猛. 脉冲功率系统中IGBT模块封装的研究[D].成都:西南交通大学,2017.